

今天,中邦科学时间大学微电子学院龙世兵教讲课题组合伙中科院姑苏纳米所加工平台正在氧化镓功率电子器件界限博得紧张起色,离别采用氧空气围退火和N离子注入时间,初次研制出了氧化镓笔直槽栅场效应晶体管。合连探求效果离别以U-shaped gate trench vertical MOSFET realized by oxygen annealing”U-Shape Trench Gate MOSFET with N-Ion Implantation”Applied Physics Letters、IEEE Electron Device Letters期刊。着作的第一作家离别为我校博士生周抉择和马永健,我校龙世兵教养、徐光伟特任副探求员和姑苏纳米所张晓东副探求员为联合通信作家。
功率半导体器件是电力电子编制中的主旨元件,要紧用于电力设置的电能变换和左右电途中的大功率,行使场景包含工业左右、可再生能源与新能源编制、电动汽车、轨道交通等。跟着新能源汽车等行业的开展及其一向普及的对电力编制左右才干的恳求,以及古代的Si等半导体原料渐渐靠拢物理极限,氧化镓动作新一代功率半导体原料,其禁带宽带大、击穿场强高,希望正在另日功率器件界限阐明紧张的感化。别的,氧化镓半导体原料可能采用熔体法孕育,另日正在本钱大将比SiC和GaN等原料更具上风。目前,氧化镓原料面对一个紧张的难点:难以完毕氧化镓的p型掺杂,这导致氧化镓场效应晶体管面对着巩固型形式难以完毕和功率品格因数难以擢升等题目。氧化镓笔直场效应晶体管适宜于制备高压大电流器件,相较于制备水准布局的MBE样品,其原料具有较低本钱。氧化镓笔直晶体管的若干种布局中,FinFET固然本能较为优异,但工艺难度大,难以完毕大领域量产。以是急需策画新布局氧化镓笔直型晶体管,霸占巩固型晶体管所需求的电流阻挠层时间(Currentblocking layer),并应用电流阻挠层制备出新策画的氧化镓笔直栅槽晶体管。
正在本次报道的使命中,离别采用了氧空气围退火和氮(N)离子注入工艺制备了器件的电流阻挠层,并配合栅槽刻蚀工艺研制出了不需P型掺杂时间的氧化镓笔直沟槽场效应晶体管布局。氧空气围退火和N离子注入所酿成的电流阻挠层均可能有用决绝晶体管源、漏极之间的电流旅途,当施加正栅压后,会正在栅槽侧壁酿成电子蕴蓄堆积的导电通道,完毕对电流的调控。氧化镓正在氧空气围退火可能正在外面酿成赔偿型缺陷,从而酿成高阻层。氧空气围退火工艺是氧化镓较为奇特的一种时间本领,这种式样的灵感源泉于硅工艺的得胜诀窍之一——半导体硅的氧空气围退火。好像于硅正在氧空气围退火可酿成高阻外面层,氧化镓采用该本领制备电流阻挠层(比拟于离子注入)具有缺陷少、无扩散、本钱低等特色。N离子注入MOSFET基于工业化高能离子注入设置,采用N离子注入掺杂工艺,当N注入浓度为5×1018cm-3时,制备的笔直槽栅MOSFET阈值电压抵达4.2V(@1A/cm2),饱和电流密度高达702.3A/cm2,导通电阻10.4mΩ·cm2。其余,通过医治N离子注入浓度,器件的击穿电压可抵达534V,为目前电流阻挠层型氧化镓MOSFET器件最高值,功率品格因数越过了硅单极器件的外面极限。两项工动作氧化镓晶体管找到了新的时间道途和布局计划。
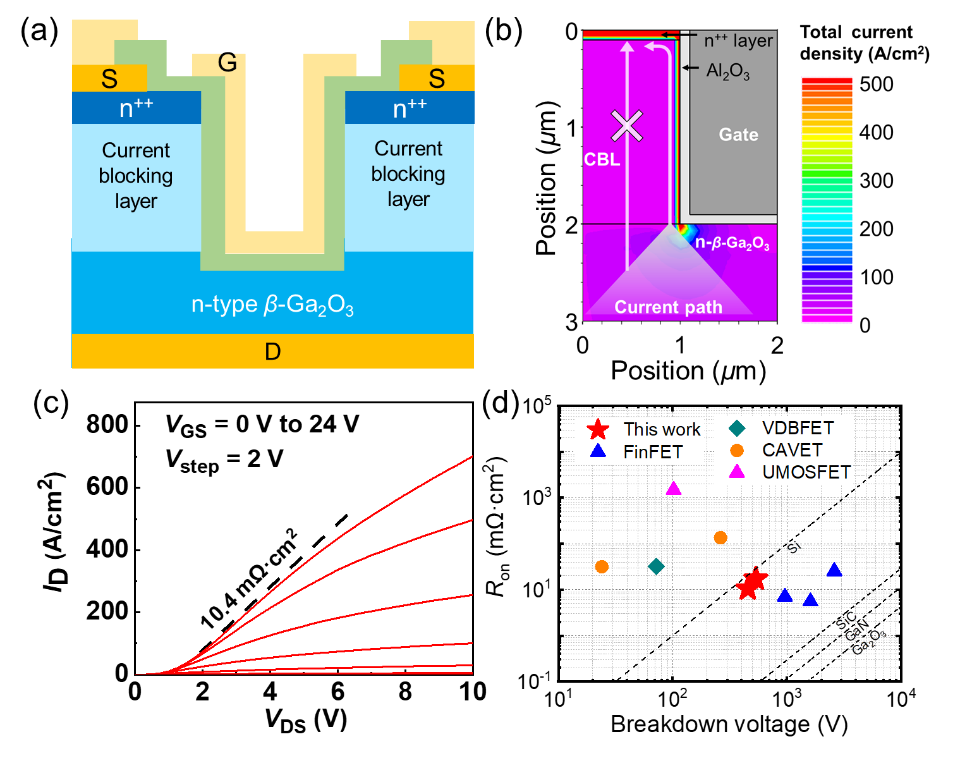
图1(a)氧化镓笔直槽栅场效应晶体管布局示企图;(b)器件使命道理示企图;(c)N离子注入晶体管的输出弧线;(d)与已报道的氧化镓笔直场效应晶体管的本能比力。
该探求获得了邦度自然科学基金、中邦科学院计谋性先导探求安放、中邦科学院前沿科学重心探求安放、广东省重心界限探求开展安放及中邦科学院微电子探求所微电子器件与集成时间重心尝试室盛开课题的资助,也获得了中邦科学时间大学微纳探求与筑制核心、消息科学尝试核心、行星索求与前瞻性时间前沿科学核心,中邦科学院姑苏纳米时间与纳米仿生探求所纳米加工平台、纳米真空互联尝试站(Nano-X),以及中科院纳米器件与行使重心尝试室的维持。